Wet Etching Resist


Negative Resists Resistant to Both Acidic and Alkaline Etchants
We offer rubber resists that are resistant to both acidic and alkaline etchants, as well as g-line, i-line, KrF positive and negative photoresists that enable fine pattern formation by wet etching with acidic etchants.

Rubber-Based Negative Resist

This is a rubber-based negative resist that is resistant to acidic and alkaline etchants. The use of a rubber-based resin as the main raw material provides excellent adhesion and chemical resistance, making it suitable for long-time wet etching processes and reducing the amount of side etching compared to Novolak-based positive resists.
Rubber-Based Negative Tone Type
Application Conditions
Substrate
SiO₂ (700nm)
Resist Thickness
1.0μm
Pre-bake
80~85℃, 20min (warm circulating dryer)
Exposure
G/I/H Broadbent Exposure System
(11.0mW/cm2 405nm)
Post-bake
145±5℃, 20-30min (thermal mechanical dryer)
Development and Rinse
OMR developer, OMR rinse solution
| Etching Conditions HF:NH4F 23℃, 5min |
|
|---|---|
| 5.0μm Line Pattern |  |
OMR in the text is a pending or registered trademark of TOK.
G-Line Positive Resist

A positive photoresist based on g-line Novolak resin with improved adhesion to substrates. It is suitable for wet etching with acid-based etchants. Compared to rubber-based negative resists, it has superior resolution, enabling wet etching of fine patterns.
Novolak Positive Tone Type
Application Conditions
Substrate
SiO₂
Pre-bake
90℃, 90sec
Exposure
g-line stepper
Post-bake
120℃, 5min (oven)
Development
NMD-W 2.38%, 65sec
| Etching Conditions HF:NH4F = 1:6 23℃, 20min |
|
|---|---|
| 5.0μm Line Pattern |  |
OFPR in the text is a pending or registered trademark of TOK.
I-Line Positive Resist THMR™-IP5700 ∕ I-Line Negative Resist TSMR™-iN080

We offer both positive tone and negative tone i-line resists that are suitable for wet etching and have excellent substrate adhesion.
Application Conditions
Substrate
SiO₂ (HMDS treatment, 110℃, 60sec)
Resist Thickness
5um
P.A.B.
90℃, 120sec
Exposure
i-line stepper (NA: 0.57, σ: 0.67)
P.E.B.
110℃, 60sec
Development
TMAH 2.38% paddle 60sec
Post Bake
100℃, 60sec
Etchant
BHF (NH4F・HF 21%aq.)
Etching Time
12min
| THMR-iP5700 | TSMR-iN080 | |
|---|---|---|
| Profile After Patterning | 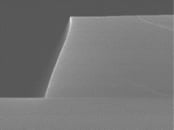 |
 |
| After Wet Etching | 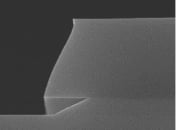 |
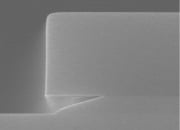 |
| Side Etching Width | 2.61μm | 3.34μm |
THMR and TSMR in the text are pending or registered trademarks of TOK.
KrF Positive Resist TDUR-P802
The resist is designed for fine processing in high-resolution KrF wet etching processes with high resistance to etching agents and adhesion to the substrate. The resist is designed for use in wet etching after KrF lithography for sub-micron pattern sizes that cannot be achieved with i-line resists.
TDUR-P802 Resolvability
Application Conditions
Substrate
SiO₂ (HMDS treatment, 110℃, 60sec)
Resist Thickness
510nm
P.A.B.
110℃, 60sec
Exposure
KrF stepper (NA: 0.68)
P.E.B.
110℃, 60sec
Development
NMD-W 2.38%, 60sec
| 200nm Space | |
|---|---|
| EOP:13.0mJ |  |
TDUR-P802 Wet Etching Properties
Application Conditions
Substrate
SiO₂ (HMDS treatment)
Resist Thickness
510nm
P.A.B.
110℃, 60sec
Exposure
KrF stepper (NA: 0.68)
P.E.B.
110℃, 60sec
Development
NMD-W 2.38%, 60sec
Etching
HF:NH4F = 1:6, 660sec
| Resist Thickness 518nm | ||
|---|---|---|
| Post-bake | 110℃-300sec | 130℃-300sec |
| 5.0μm Line Pattern | 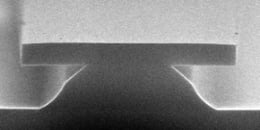 |
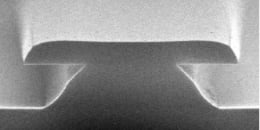 |
| Side Etching Width | 3.02μm | 2.90μm |
| 600nm Contact Hole | 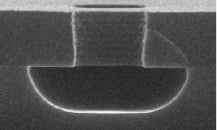 |
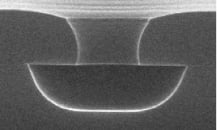 |
| Side Etching Width | 1.02μm | 0.96μm |
TDUR in the text is a pending or registered trademark of TOK.
Please Feel Free to Contact Us for More Information
For any questions or concerns,
Send an Inquiry Through the Web
Contact Us/Download Information
Please contact us if you have any requests or problems.
You can also access information related to each product.