KrF Resist


Development of Chemically Amplified Resists
Compatible with 248nm Laser
Since the latter half of 1990, we have been developing chemically amplified resists that are compatible with 248nm long krypton fluoride (KrF) laser light sources. Throughout these years, we have been offering a wide range of products such as positive type, negative type, and thick film type to meet the various needs of our customers.
Positive KrF Resist for Lines
This resist was designed and developed for line formation. It is used in a wide range of applications including metal and implant applications.
TDUR™-P3435
Conditions
Substrate
Si with HMDS
Resist Thickness
250nm; (Nf:1.56 at 633nm) /
190nm; (Nf:1.56 at 633nm)
Pre-bake
100℃, 60sec
TARC
TARC 44nm (RI=1.44 at 633nm)
TARC Bake
60℃, 60sec
Exposure
KrF stepper (NA: 0.75, σ: 0.60)
P.E.B
110℃, 60sec
Reticle
TOK-248-010 (6% half tone)
Development
NMD-3 2.38%, 23℃, 60sec, LD nozzle
Post-bake
100℃, 60sec
Target
Target CD: 150nm line
(Mask: 150nm, Pitch: 330nm)
Overview
| TPR=250nm | TPR=190nm | ||
|---|---|---|---|
| Profile | LS | 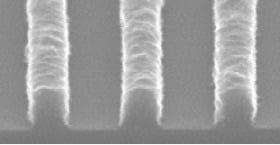 |
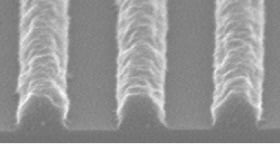 |
| ISO | 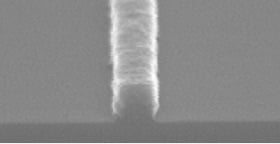 |
 |
|
| Trench |  |
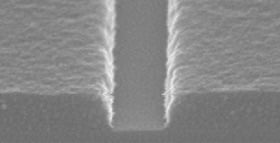 |
|
Positive KrF Resist for Holes
This resist was designed and developed for hole formation. It is used in various processes including contact hole formation.
TDUR-P4197T PM
Substrate
BARC
Film Thickness
430nm(R.I.:1.56@633nm)
Pre-bake
90℃, 60sec
Exposure
KrF stepper (NA: 0.75, σ: 2/3 annular)
Mask
TOK Reticle (HT 6%)
P.E.B
110℃, 60s
Development
NMD-3 2.38%, 60s, Paddle
Target: Hole/Mask/Pitch = 123/150/300
| -0.20 | -0.15 | -0.10 | -0.05 | 0 | 0.05 | 0.10 | |
|---|---|---|---|---|---|---|---|
| TPR:340nm Exp:75mJ/cm2 |
 |
 |
 |
 |
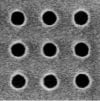 |
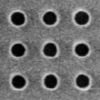 |
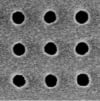 |
| TPR:430nm Exp:79mJ/cm2 |
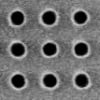 |
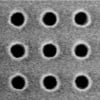 |
 |
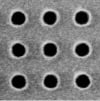 |
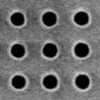 |
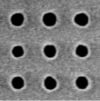 |
|
| TPR:520nm Exp : 86mJ/cm2 |
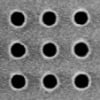 |
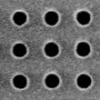 |
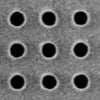 |
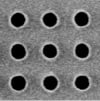 |
 |
 |
Negative KrF Resist
A wide range of KrF resists are available for the photolithography and post process applications that require properties of negative type resists.
TDUR-N Series
Substrate
BARC
Resist
TDURTM-N Series
Film Thickness
400nm (Nf:1.58)
Pre-bake
90-100℃, 60sec
Exposure
KrF stepper (θ: 2/3 annular)
P.E.B.
110℃, 60s
Reticle
HT 6%
Development
NMD-3 2.38%, 60s
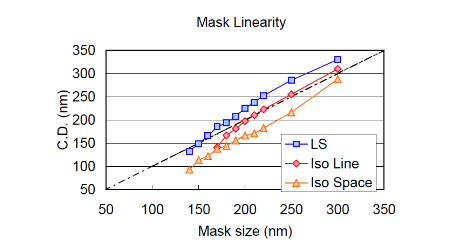
| TDUR-N Series 38mJ / cm2 |
TDUR-N Series 38mJ / cm2 |
TDUR-N Series 38mJ / cm2 |
|
|---|---|---|---|
| 300nm |  |
 |
 |
| 250nm |  |
 |
 |
| 200nm |  |
 |
 |
| 180nm |  |
 |
 |
| 170nm |  |
 |
 |
| 160nm |  |
 |
 |
| 150nm |  |
 |
|
| 140nm |  |
 |
|
| 130nm |  |
 |
Thick Film KrF Resist
A positive resist that can ensure a film thickness of even 10μm, this product is used for thick film plating and staircase layer formation.
TDUR-P9001 CO
Profile
- Specifically designed resist for thick film patterning
- High resolution and vertical profile even in thick film
- ISO Trench Target CD Size: 1.5μm
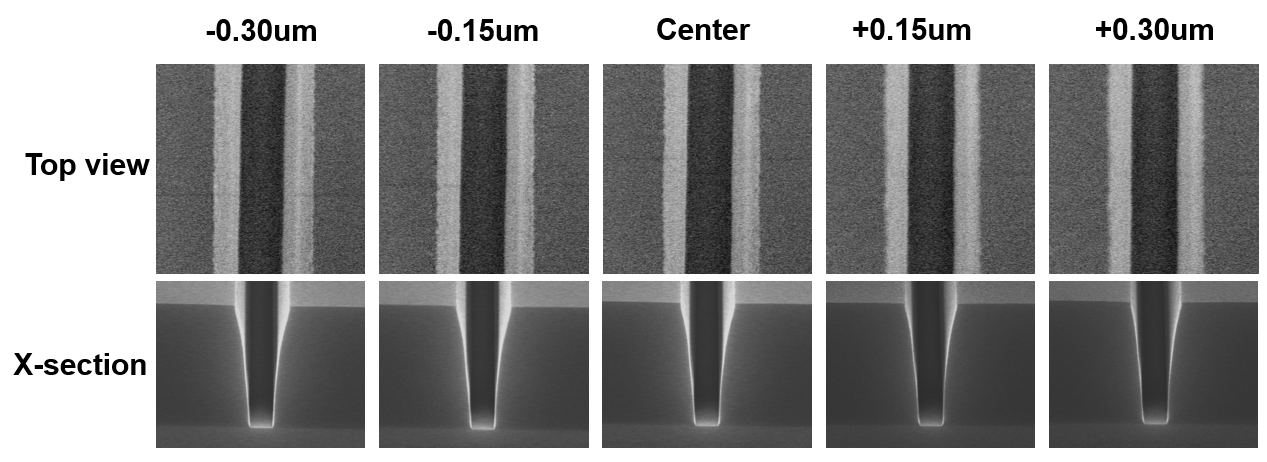
Conditions
Substrate
Si with HMDS
Resist Thickness
9.2μm (RI: 1.56)
Pre-bake
140℃, 60sec
Exposure
KrF stepper (NA: 0.55, σ: 0.49)
Reticle
Binary Reticle
P.E.B
110℃, 60sec
Development
NMD-3 2.38%, 23℃, 60sec
Post-bake
100℃, 60sec
Target CD
Trench: 1.5μm space / 16.5μm pitch ; Dot: 1.5μm space / 12.0μm pitch
TDUR in the text is a pending or registered trademark of TOK.
Please Feel Free to Contact Us for More Information
For any questions or concerns,
Send an Inquiry Through the Web
Contact Us/Download Information
Please contact us if you have any requests or problems.
You can also access information related to each product.