G- and I-Line Resist


General Purpose G- and I-Line Resists for
Semiconductors and MEMS
We offer both positive and negative resists for g-, h-, and i-line projection exposure with long wavelengths as well as for high NA g- and i-line stepper exposure systems. We offer a wide range of resists, including thick film types, high-sensitivity types, dye-infused types for high-reflection substrates such as polysilicon and tungsten wiring, etc. The following is a list of our representative products. Please feel free to contact us for regarding these or additional types of products.
G-Line Resist
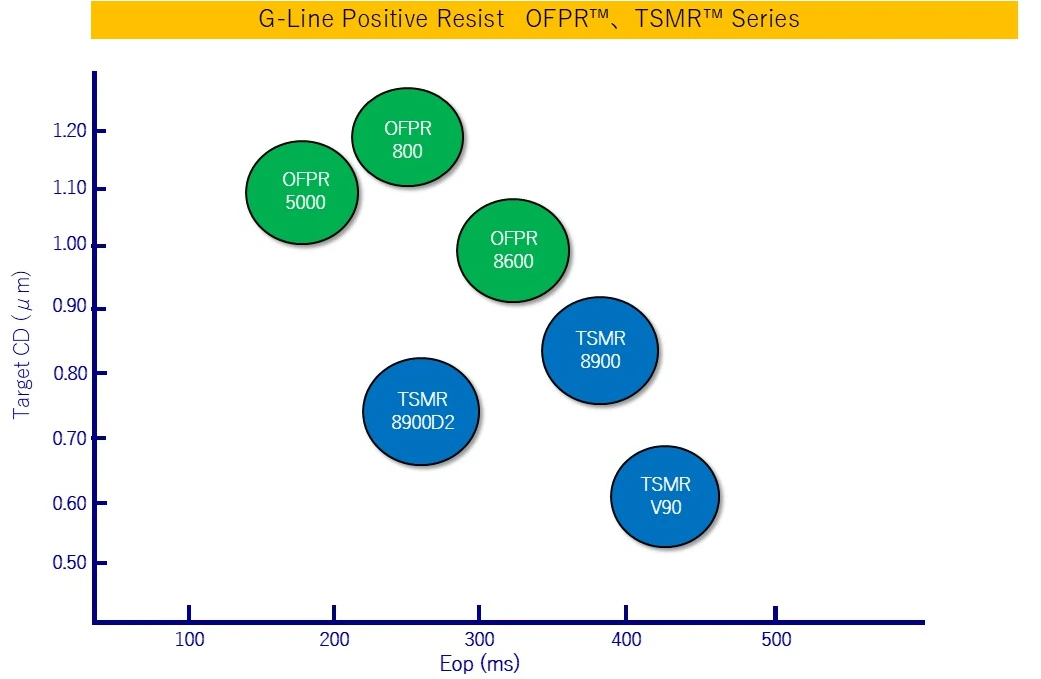
Substrate
Bare-Si (HMDS coated)
Film thickness
1.26μm
Pre-bake
Pre-bake :90℃, 90sec
(110℃, 90sec /no post exposure bake)
Exposure
g-line stepper (NA: 0.54)
Post Exposure
Bake (P.E.B.)
110℃, 90sec
(alternatively, no P.E.B.)
Development
NMD-3 2.38%, 60sec
Post-bake
110℃, 90sec (proximity)
G-Line Positive Photoresist
OFPR™Series、TSMR™Series
These are positive photoresists with a photosensitive wavelength corresponding to the g-line (436nm).
Depending on the series, high resolution target dimensions of down to 0.7μm are possible with minimal striation. Within the OFPR™ series, OFPR™-800 has been widely used as a g-line positive photoresist in combination with the organic alkaline developer OFPR™-NMD-3 2.38%. The TSMR™ series is characterized by high-resolution resists for use with higher NA steppers. We also offer a wide variety of products, including the TSMR-V series, which features a rectangular shape, and the dye-infused TSMR-CR, which is designed for use with high-reflection substrates.
TSMR™-V90
Features
- Excellent resolution and overall fidelity of 0.45μm with NA 0.54 stepper
- Wide DOF tolerance to maintain good pattern quality
- Higher sensitivity and higher throughput
- Excellent dimension control due to reduced standing wave effects
Substrate
Si (HMDS)
Film thickness
1.25μm
Pre-bake
100℃, 60sec
Exposure
NSR-1505G7E
P.E.B
120℃, 90sec
Development
NMD-3 2.38%,
23℃, 60sec
Resolvability
| 0.4μm | 0.45μm | 0.5μm | 0.6μm | 0.7μm | 0.8μm | |
|---|---|---|---|---|---|---|
| TSMR-V90 Eth:270ms Eop:550ms (0.8μm) |
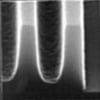 |
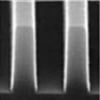 |
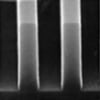 |
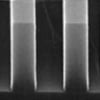 |
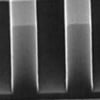 |
 |
OFPR&TSMR in the text is a pending or registered trademark of TOK.
Please Feel Free to Contact Us for More Information
For any questions or concerns,
Send an Inquiry Through the Web
I-Line Resist
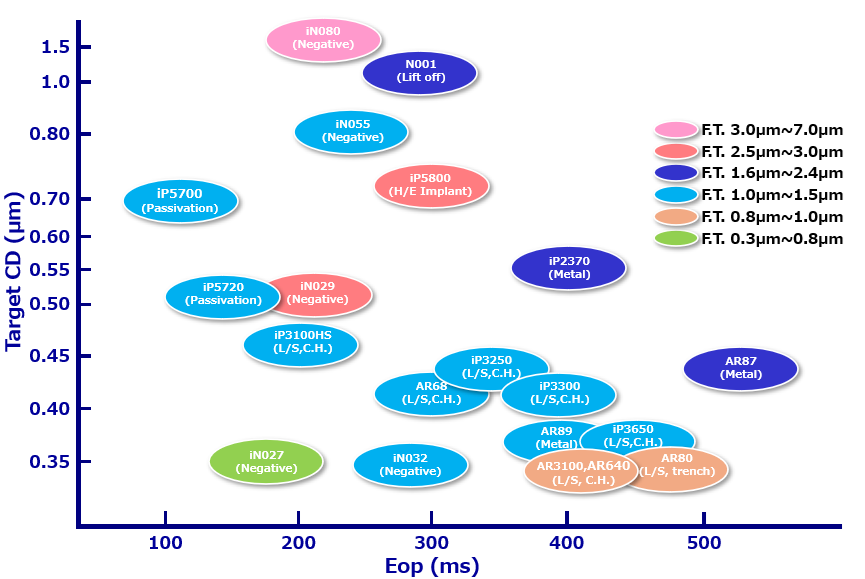
Substrate
Bare-Si (HMDS coated)
Film thickness
Refer Above
Pre-bake
90℃, 90sec (proximity)
Exposure
i-line stepper (NA: 0.57, σ: 0.56)
P.E.B.
110℃, 90sec
(alternatively, no P.E.B.)
Development
NMD-3 2.38%, 60sec
Post-bake
110℃, 90sec (proximity)
I-Line Positive Photoresist
TSMR™、THMR™-iP、TDMR™-AR Series
A photoresist with a photosensitive wavelength corresponding to the i-line (365nm). High resolutions of down to 0.35μm lines and 0.4μm holes can be achieved with minimal striation. It is also easy to develop with TMAH, has low metal impurities such as Na and Fe, and is easy to strip away.
TDMR™-AR80
High-resolution i-line positive photoresist. Excellent for fine pattern formation.
Substrate
Si (HMDS)
Film thickness
0.84μm
Pre-bake
90℃, 90sec
Exposure
i-line stepper (NA: 0.57)
P.E.B
110℃, 90sec
Development
NMD-3 2.38%, 23℃, 60sec
Resolvability
Eth:190ms Eop:465ms
| 0.28μm | 0.30μm | 0.35μm | 0.40μm |
|---|---|---|---|
 |
 |
 |
 |
DOF Performance
0.35μmL/S Eth:220ms Eop:540ms Film Thickness 1.05μm
| 0 |
|---|
 |
| 0.2 | 0.4 | 0.6 | 0.8 | 1.0 |
|---|---|---|---|---|
 |
 |
 |
 |
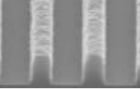 |
| -0.2 | -0.4 | -0.6 | -0.8 | -1.0 |
 |
 |
 |
 |
DOF Performance
0.40μmC/H Eth:167ms Eop:779ms Film Thickness 0.84μm
| 0 |
|---|
 |
| 0.2 | 0.4 | 0.6 | 0.8 | 1.0 |
|---|---|---|---|---|
 |
 |
 |
 |
|
| -0.2 | -0.4 | -0.6 | -0.8 | -1.0 |
 |
 |
 |
 |
 |
TSMR™-CR57i10
The dye content prevents halation caused by reflected light on Al and other high-reflection substrates,
enabling patterning.
Substrate
AI-Si
Film thickness
3.5μm
Pre-bake
90℃, 60sec
Exposure
i-line stepper (NA:0.50 σ:0.60)
P.E.B.
120℃, 60sec
Development
NMD-3 2.38%, 23℃, 65sec
Post-bake
100℃, 60sec
Resolvability
Eop 1.5μL/S
| 0.8μm | 0.9μm | 1.0μm | 2.0μm | 3.0μm | 5.0μm |
|---|---|---|---|---|---|
 |
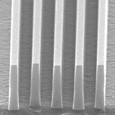 |
 |
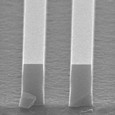 |
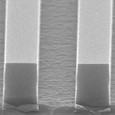 |
 |
DOF Performance
Eop 1.55μm L/S 350ms Film Thickness 2.1μm
| 0.0μm |
|---|
 |
| -0.3μm | -0.6μm | -0.9μm | -1.2μm | -1.5μm | -1.8μm | -2.1μm | 2.4μm |
|---|---|---|---|---|---|---|---|
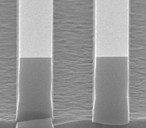 |
 |
 |
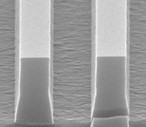 |
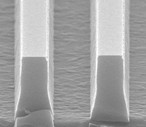 |
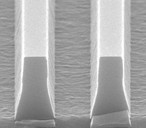 |
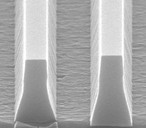 |
 |
| +0.3μm | +0.6μm | +0.9μm | +1.2μm | +1.5μm | +1.8μm | +2.1μm | +2.4μm |
 |
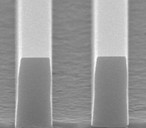 |
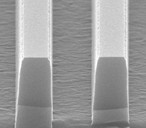 |
 |
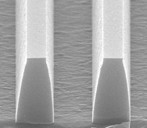 |
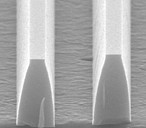 |
 |
 |
I-Line Negative Photoresist
TSMR-iN Series
This is a negative photoresist with a photosensitive wavelength corresponding to the i-line (365nm). It has high heat resistance and high wet/dry etching resistance.
TSMR™-iN080
It is excellent for covering stepped substrates with thicker films and while reducing developer residue.
Resolvability
Substrate
Si (HMDS)
Film thickness
3μm
Pre-bake
90℃, 120sec
Exposure
i-line stepper (NA: 0.57)
P.E.B.
110℃, 60sec
Development
NMD-3 2.38%, 23℃, 60sec
Post-bake
100℃, 60sec
700nm
| -0.6 | -0.3 | 0 | 0.3 |
|---|---|---|---|
 |
 |
 |
 |
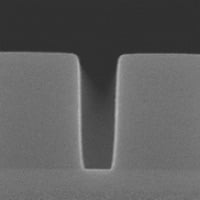 |
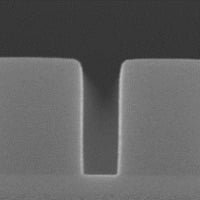 |
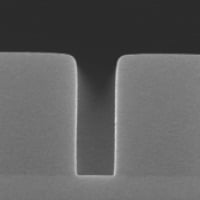 |
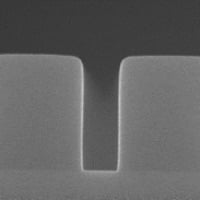 |
DOF Performance
Substrate
Si (HMDS)
Film thickness
5.8μm
Pre-bake
90℃, 120sec
Exposure
g-line stepper (NA: 0.54)
P.E.B.
110℃, 60sec
Development
NMD-3 2.38%, 120sec
5μm Space
| 0 |
|---|
 |
| 1.0 | 1.5 | 2.5 | 3.0 | 3.5 |
|---|---|---|---|---|
 |
 |
 |
 |
 |
| -1.0 | -1.5 | -2.5 | -3.0 | -3.5 |
 |
 |
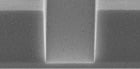 |
 |
 |
Heat Resistance
Film Thickness: 5.8μm, Post-bake Time: 300sec
| none |
|---|
 |
| 140℃ | 150℃ | 160℃ | 200℃ | 250℃ | 300℃ |
|---|---|---|---|---|---|
 |
 |
 |
 |
 |
 |
TSMR, THMR and TDMR in the text are pending or registered trademarks of TOK.
Please Feel Free to Contact Us for More Information
For any questions or concerns,
Send an Inquiry Through the Web
Contact Us/Download Information
Please contact us if you have any requests or problems.
You can also access information related to each product.