ArFレジスト


最先端ArFリソグラフィー技術に対応するレジストラインナップ
フォトレジストのトップメーカーの当社はArF ドライ露光、液浸(Immersion)露光、DTDやPTD等のマルチパターニング技術の半導体ArFフォトリソプロセスによる先端微細パターニングに対応する各種フォトレジストをご提供しており、この分野でトップマーケットシェアを確保しています。
関連技術情報
Line用ポジ型ArFレジスト
Line形成用として設計、開発を行なったレジストです。
TARF-P6111
条件
基板
BARC on Si
レジスト膜厚
250nm
プリベーク
130℃-60秒
露光
ArFステッパー
露光条件
NA=0.85, Sigma=0.60
マスク
Binary
P.E.B
130℃-60秒
現像
TMAH 2.38%, LDノズル, 30秒
データ
| 130nm LS (19.6mJ) |
 |
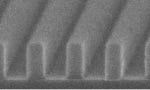 |
|---|---|---|
| 130nm Iso-L |  |
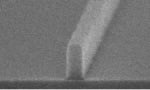 |
| 130nm Iso-S |  |
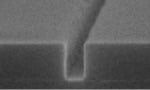 |
| LS | Iso-L | Iso-S | |
|---|---|---|---|
| DOF@5% EL +/- 10% CD |
0.39um | 0.33um | 0.17um |
| DOF (um) | -0.15 | -0.12 | -0.09 | -0.06 | -0.03 | F.C | +0.03 | +0.06 | +0.09 | +0.12 | +0.15 |
|---|---|---|---|---|---|---|---|---|---|---|---|
| 130nm LS |  |
 |
 |
 |
 |
 |
 |
 |
 |
 |
 |
| 130nm iso-L |  |
 |
 |
 |
 |
 |
 |
 |
 |
 |
 |
| 100nm iso-S |  |
 |
 |
 |
 |
 |
 |
 |
 |
 |
 |
Hole用ポジ型ArFレジスト
Hole形成用として設計、開発を行なったレジストです。
TARF-P7052
データ
| -0.30 | -0.20 | -0.10 | 0 | +0.01 | +0.20 | +0.30 | |
|---|---|---|---|---|---|---|---|
| ピッチ 300nm |
 |
 |
 |
 |
 |
 |
 |
文中のTARFはTOKの出願中または登録商標です
材料についてのご相談は、お気軽にお問い合わせください。
ご質問・ご相談などお気軽に
WEBからのお問い合わせ
お問い合わせ・資料ダウンロード
ご要望やお困りごとがありましたらお問い合わせください。
各製品に関する資料もダウンロードいただけます。

