深堀ドライエッチング用レジスト


Siの深堀ドライエッチングに最適な厚膜ポジレジスト
MEMSやTSVなどで行われるSi基板深堀エッチングのボッシュ式、非ボッシュ式の各ドライエッチング方式に応じた厚膜レジストをご用意しております。
PMER P-CY1000
ノンボッシュ法(RIE)によるSi深堀ドライエッチングに対応
ドライエッチング時の低温基板温度条件下でも高いクラック耐性を有します (-15℃/30min)。
PMER P-CY1000は良好な耐クラック性を有し、非ボッシュ式シリコンエッチング(RIE式)時の基板冷却により発生するレジストクラックを防止して安定したエッチングが可能となります。
深堀イオンエッチング
| エッチング処理前 | エッチング後レジスト除去 | |
|---|---|---|
| PMER P-CY1000 | 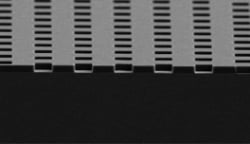 Si基板上 10μmパターン |
 |
クラックテスト
| パターンエリア | レジストエリア | |
|---|---|---|
| PMER P-CY1000 |
 クラック発生なし |
 クラック発生なし |
| 通常品 i線 レジスト |
 クラック発生 |
 クラック発生 |
文中のPMERはTOKの出願中または登録商標です
材料についてのご相談は、お気軽にお問い合わせください。
ご質問・ご相談などお気軽に
WEBからのお問い合わせ
お問い合わせ・資料ダウンロード
ご要望やお困りごとがありましたらお問い合わせください。
各製品に関する資料もダウンロードいただけます。