ウェットエッチング用レジスト


酸性、アルカリ性どちらのエッチャントにも耐性をもつネガレジスト
酸性、アルカリ性エッチャントのどちらにも耐性を持ったゴム系レジストと、酸系エッチャントによるウェットエッチング処理にて微細パターン形成が可能な、g線、i線、KrF ポジ及びネガの両タイプのフォトレジストをご用意しております。

ゴム系ネガレジスト OMR-100

酸性・アルカリ性エッチャントに耐性を持ったゴム系ネガレジストです。ゴム系樹脂を主原料に使用しているため、密着性及び薬液耐性に優れノボラック樹脂系ポジ型レジストに比べ長時間のウェットエッチング工程に対応し、サイドエッチング量を小さくできます。
ゴム系ネガティブトーンタイプ
実装条件
下地
SiO2 (700nm)
レジスト膜厚
1.0μm
プリベーク
80~85℃ 20分 (温風循環乾燥機)
露光
G/I/H ブロードバント露光機
(11.0mW/㎠ 405nm)
現像・リンス
OMR現像液, OMRリンス液
ポストベーク
145±5℃ 20~30分 (温風循環乾燥機)
| エッチング条件 HF:NH4F 23℃-5分 |
|
|---|---|
| 5.0μm ラインパターン |
 |
文中のOMRはTOKの出願中または登録商標です
G線ポジレジスト OFPR-800

基板との密着性を向上させたG線ノボラック樹脂系ポジ型フォトレジストです。酸系エッチャントのウェットエッチングに適用可能です。ゴム系ネガレジストに比べ解像性に優れており微細なパターンのウェットエッチングが可能となります。
ノボラック系ポジティブトーンタイプ
実装条件
下地
SiO2
プリベーク
90°C-90秒
露光
G線ステッパー
現像
NMD-W 2.38% 65秒
ポストベーク
120℃-5分(オーブン)
| エッチング条件 HF:NH4F=1:6 23℃-20分 |
|
|---|---|
| 5.0μm ラインパターン |
 |
文中のOFPRはTOKの出願中または登録商標です
I線ポジレジスト THMR-IP5700/I線ネガレジスト TSMR-iN080

ウェットエッチングに適用可能な基板密着性に優れたポジティブトーン、ネガティブトーンの両タイプのi線レジストご用意しております。
実装条件
下地
SiO2 (HMDS 110℃-60秒処理)
レジスト膜厚
5um
プリベーク
90℃-120秒
露光
I線ステッパー (NA 0.57, σ 0.67)
P.E.B.
110℃-60秒
現像
TMAH 2.38% パドル60秒
ポストベーク
100℃-60秒
エッチャント
BHF(NH4F・HF 21%aq.)
エッチング時間
12分
| THMR-iP5700 | TSMR-iN080 | |
|---|---|---|
| パターニング後 プロファイル |
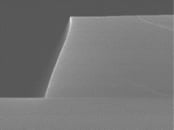 |
 |
| ウェット エッチング後 |
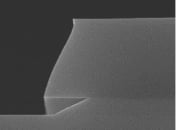 |
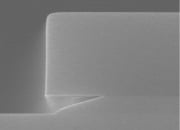 |
| サイドエッチング幅 | 2.61μm | 3.34μm |
文中のTHMR、TSMRはTOKの出願中または登録商標です
KrFポジレジスト TDUR-P802
エッチャント耐性と基板との密着性を確保させた、高解像KrFウェットエッチング工程用の微細加工用レジストです。I線レジストで達成できないサブミクロンのパターンサイズに対してKrFリソグラフィーでパターニング後、ウェットエッチングに適用可能なポジ型レジストです。
TDUR-P802 解像性
実装条件
下地
SiO2 (HMDS 110℃-60秒処理)
レジスト膜厚
510nm
プリベーク
110℃-60秒
露光
KrFステッパー (NA:0.68)
P.E.B.
110℃-60秒
現像
NMD-3 2.38% 60秒
| 200nm スペース | |
|---|---|
| EOP:13.0mJ |  |
TDUR-P802 ウェットエッチング特性
実装条件
下地
SiO2 (HMDS処理)
レジスト膜厚
518nm
プリベーク
110℃-60秒
露光
KrFステッパー(NA:0.68)
P.E.B.
110℃-60秒
現像
NMD-W 2.38% 60秒
エッチング
HF:NH4F=1:6 660秒
| レジスト膜厚 518nm | ||
|---|---|---|
| ポストベーク | 110℃-300秒 | 130℃-300秒 |
| 5.0μm ラインパターン |
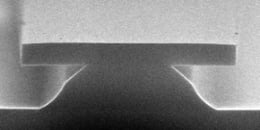 |
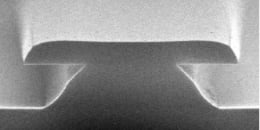 |
| サイドエッチング幅 | 3.02μm | 2.90μm |
| 600nm コンタクトホール |
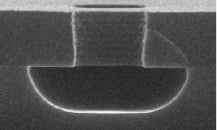 |
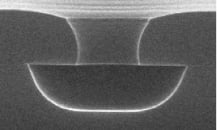 |
| サイドエッチング幅 | 1.02μm | 0.96μm |
文中のTDURはTOKの出願中または登録商標です
材料についてのご相談は、お気軽にお問い合わせください。
ご質問・ご相談などお気軽に
WEBからのお問い合わせ
お問い合わせ・資料ダウンロード
ご要望やお困りごとがありましたらお問い合わせください。
各製品に関する資料もダウンロードいただけます。