TLDPの開発

ダイシング保護膜とは?
半導体チップの製造過程は、半導体チップを製造するためのマスクを形成する「設計/マスク作成」、ウエハ上に集積回路を作りこむ「前工程」、前工程で作られた半導体チップを各種パッケージに封入し、製品化する「後工程」の大きく3つに分かれています。
「ダイシング保護膜」は「後工程」の中でも半導体チップをパッケージに収納するために専用のカッター(ダイシングソー)でウエハをチップ状に切り出す「ダイシング」工程で使用されます。
文中のTLDPはTOKの出願中または登録商標です
組立・パッケージング・検査プロセス(後工程)
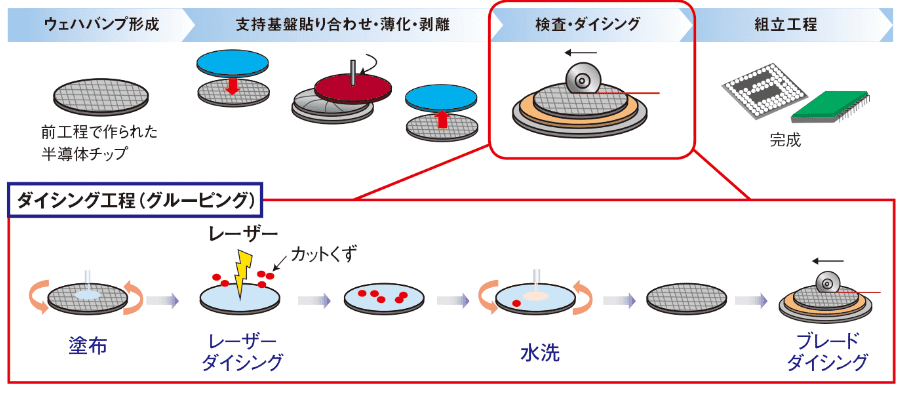
ダイシング保護膜とは
基板切断時に基板を保護する「ダイシング保護膜」はレーザーダイシング時のカットくず付着抑制を目的に使用されています。ダイシングの際に発生する酸化物やメタル溶解物などのカットくずがウエハの表面に付着してしまうと、その後の洗浄工程で完全に除去することが難しく、できあがった電子部品や電子回路の不良の原因になってしまいます。
「ダイシング保護膜」は原材料に水に溶ける性質を持つ樹脂を使用しているため、加工面にあらかじめ塗布することで、基板へのカットくずの付着を防ぐとともに、加工後の純水による洗浄工程でカットくずを完全に除去することを可能にします。
ダイシング保護膜ありなしの比較
ダイシング保護膜なし

ダイシング保護膜あり
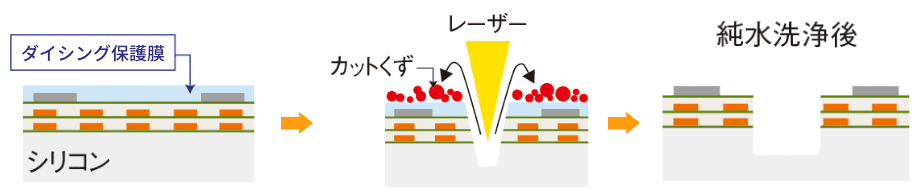
関連製品
お問い合わせ・資料ダウンロード
ご要望やお困りごとがありましたらお問い合わせください。
各製品に関する資料もダウンロードいただけます。
